
中國粉體網訊 隨著AI、高性能計算(HPC)及車用電子等新興應用的爆發式擴張,芯片設計正加速從通用化向場景化精準適配轉型。這一演進不僅重塑了芯片架構,更對半導體封裝的性能極限與成本控制提出前所未有的嚴苛要求。面對雙重壓力,傳統封裝技術在高密度集成、高速信號傳輸等核心需求前漸露短板,而面板級封裝(PLP)與玻璃基板恰如破局關鍵應運而生,成為突破產業瓶頸的核心技術路徑。
面板級封裝的核心優勢在于“化圓為方”的創新思路,將晶圓級封裝擴展至方形大尺寸基板,使面積利用率大大增加,遠超傳統封裝方式。而這一技術的落地,離不開高密度金屬化重布線層(RDL)的支撐,作為實現高速傳輸與高密度整合的核心工藝,RDL通過微米級精密布線打破芯片I/O限制,為多芯片集成提供可能。

板級封裝產品 來源:Manz亞智科技
Manz亞智科技是全球領先的半導體面板級封裝設備制造商,深耕電鍍及濕制程設備領域,從實驗室的小量定制到標準化模組,都能提供完整的設備解決方案,其設備矩陣的技術優勢貫穿RDL制程各關鍵環節,清洗設備以高效去除能力保障制程潔凈度,直接提升產品良率;酸洗設備針對玻璃與ABF材料的表面處理技術,顯著增強后續工序的附著力;顯影設備憑借均勻性與穩定性優化圖形轉移效果;電鍍設備實現高均勻性電沉積,確保線路厚度與電性一致;剝膜設備可實現干膜濕膜無殘留剝離;蝕刻設備更達到90%的均勻性標準,保障制程質量穩定。這套完整設備方案,為RDL工藝的精細化與規模化提供了核心支撐。
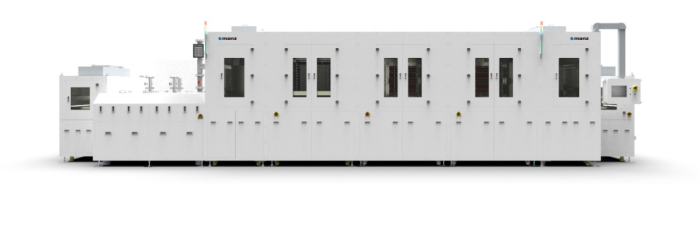
電鍍設備 來源:Manz亞智科技
玻璃基板憑借低介電常數、低損耗、低翹曲、高平坦度及優異尺寸穩定性的綜合優勢,在高速運算與高頻傳輸場景中展現出卓越性能,其介電常數僅約為硅材料的三分之一,損耗因子更是比硅材料低2–3個數量級,這兩大核心特性可有效降低襯底損耗與寄生效應,既能顯著提升信號完整性、減少信號衰減與噪聲干擾,又能優化高速信號傳輸效率及電源分配網絡的供電穩定性,最終為芯片持續穩定運行提供可靠保障。
盡管玻璃基板具備顯著的性能優勢,但其應用推廣長期受限于TGV(玻璃通孔)技術的發展瓶頸。憑借在化學濕制程、電鍍及自動化領域積累的深厚技術沉淀,Manz亞智科技已實現在不同類型、不同厚度的玻璃基板上,精準制備出高縱深比、高真圓度(>95%)的TGV結構。
具體來看,Manz亞智科技的TGV制程采用“激光打孔+化學蝕刻”協同工藝,能夠穩定形成縱深比大于10:1的直通孔,后續通過電鍍填銅完成金屬化處理時,還可對孔徑與深寬比實現精細化控制。這一系列技術手段從結構層面出發,為信號傳輸的穩定性與可靠性提供了核心保障。
針對不同厚度的玻璃基板,Manz亞智科技進一步開發差異化解決方案,通過定制化溫控系統與專屬藥液配方,有效解決厚基板加工易出現的孔徑偏差問題,顯著提升全基板范圍內的孔徑均勻性,滿足多樣化應用場景下的高精度加工需求。
相信未來,隨著下游應用需求的持續深化與技術的不斷演進,PLP與玻璃基板有望成為半導體封裝的主流方向,而以Manz亞智科技為代表的設備企業,也將在這場產業變革中持續發揮技術引領作用,助力全球半導體產業突破瓶頸,邁向更高階的發展階段。
參考來源:
Manz亞智科技官網
張興治.芯片封裝用玻璃基板通孔加工和填充技術
(中國粉體網編輯整理/月明)
注:圖片非商業用途,存在侵權告知刪除!


